封裝的不同層級實際代表著互連密度的不同。晶圓通常采用光刻工藝;一級封裝對應 IC 載板封裝,把芯片特征尺寸放大到與基板特征尺寸對應的 I/O輸出,實現芯片和基板的互連;二級封裝對應 PCB 封裝,相當于把基板的特征尺寸放大到 PCB 特征尺寸,實現信號的互連。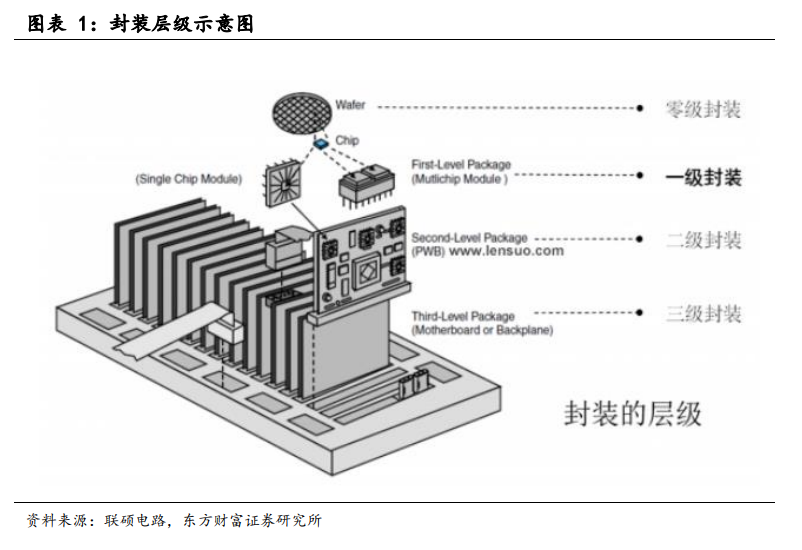 IC 載板主要用于支撐以及電氣連接。IC 載板是半導體封裝件的重要組成,主要作用:一是介于芯片與常規印制電路板(多為主板,母板,背板)之間,實現電氣連接(過渡);二是為芯片提供保護和支撐,形成散熱的通道,并且使封裝件達到符合標準安裝尺寸。
IC 載板主要用于支撐以及電氣連接。IC 載板是半導體封裝件的重要組成,主要作用:一是介于芯片與常規印制電路板(多為主板,母板,背板)之間,實現電氣連接(過渡);二是為芯片提供保護和支撐,形成散熱的通道,并且使封裝件達到符合標準安裝尺寸。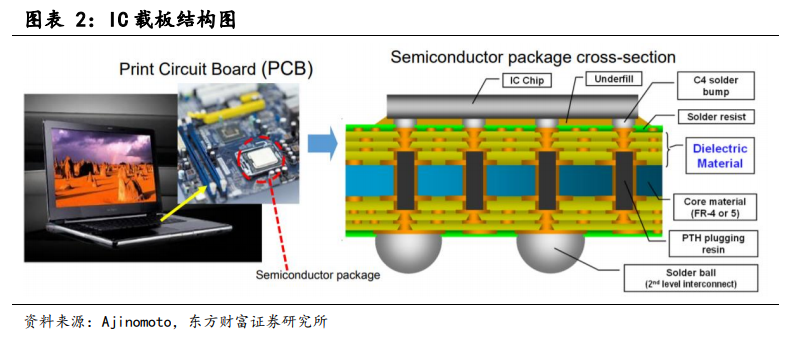 mSAP 成本低,良率高,成為主流工藝。減成法是通過蝕刻去除覆銅板表面上不需要的銅箔以獲取導電圖形,該方法最大的問題是在蝕刻過程中,銅層側面也會被刻蝕一部分(側蝕),側蝕的存在使得 PCB 的最小線寬/線距只能大于50um/50um;加成法在需要導電圖形區域先沉積導電金屬層,然后進行化學電鍍加厚導電圖形,該方法對基材和工藝流程要求很高,成本高,產量不大,主要用于生產 WB 或 FC 覆晶載板,其制程可達 12μm/12μm;半加成法是指用干膜將不需要的圖形覆蓋,利用圖形電鍍加厚所需要即未被干膜覆蓋的電路圖形,再通過蝕刻將不需要的部分快速蝕刻掉獲得最后的電路圖形;改良型半加成法(mSAP)是半加成法技術之上而得,其生產良率大幅度提高,生產成本下降,是目前精細電路線路載板最主流的制造方法,大量應用于 CSP、WB 和 FC 覆晶載板等精細線路載板的制造。
mSAP 成本低,良率高,成為主流工藝。減成法是通過蝕刻去除覆銅板表面上不需要的銅箔以獲取導電圖形,該方法最大的問題是在蝕刻過程中,銅層側面也會被刻蝕一部分(側蝕),側蝕的存在使得 PCB 的最小線寬/線距只能大于50um/50um;加成法在需要導電圖形區域先沉積導電金屬層,然后進行化學電鍍加厚導電圖形,該方法對基材和工藝流程要求很高,成本高,產量不大,主要用于生產 WB 或 FC 覆晶載板,其制程可達 12μm/12μm;半加成法是指用干膜將不需要的圖形覆蓋,利用圖形電鍍加厚所需要即未被干膜覆蓋的電路圖形,再通過蝕刻將不需要的部分快速蝕刻掉獲得最后的電路圖形;改良型半加成法(mSAP)是半加成法技術之上而得,其生產良率大幅度提高,生產成本下降,是目前精細電路線路載板最主流的制造方法,大量應用于 CSP、WB 和 FC 覆晶載板等精細線路載板的制造。