光刻膠按顯示的效果,可分為正性光刻膠和負性光刻膠。如果顯影時未曝光部分溶解于顯影液,形成的圖形與掩膜版相反,稱為負性光刻膠;如果顯影時曝光部分溶解于顯影液,形成的圖形與掩膜版相同,稱為正性光刻膠。由于負性光刻膠顯影時易變形和膨脹,分辨率通常只能達到 2 微米,因此正性光刻膠的應用更為普及。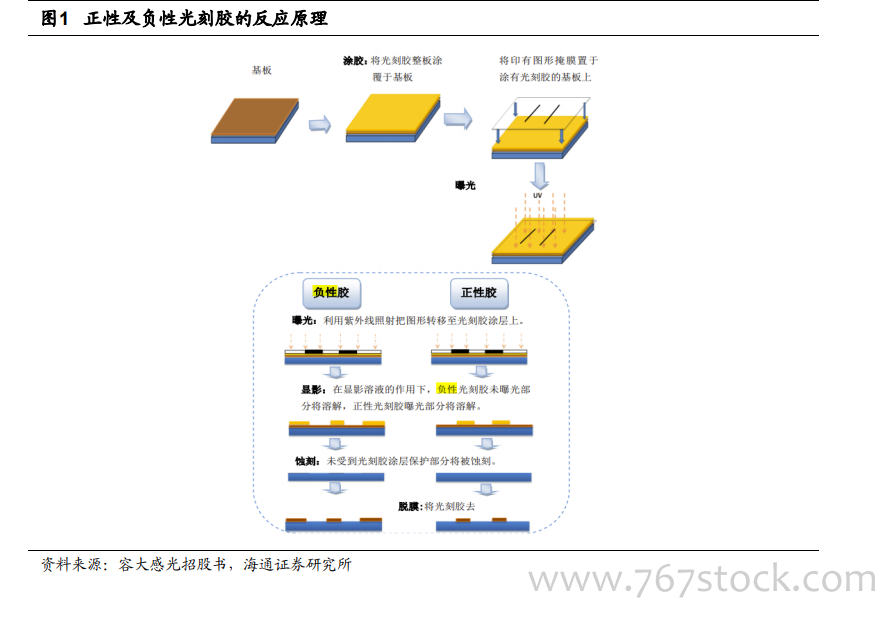
按照應用領域,光刻膠可以劃分為半導體用光刻膠、平板顯示用光刻膠、PCB 光刻膠。隨著科技的發展,現代電子電路越發向細小化集成化方向發展,隨著對線寬的不同要求,光刻膠的配方有所不同,但應用相同,都是用于微細圖形的加工,按照應用領域,光刻膠可以劃分為半導體用光刻膠、平板顯示用光刻膠、PCB 光刻膠。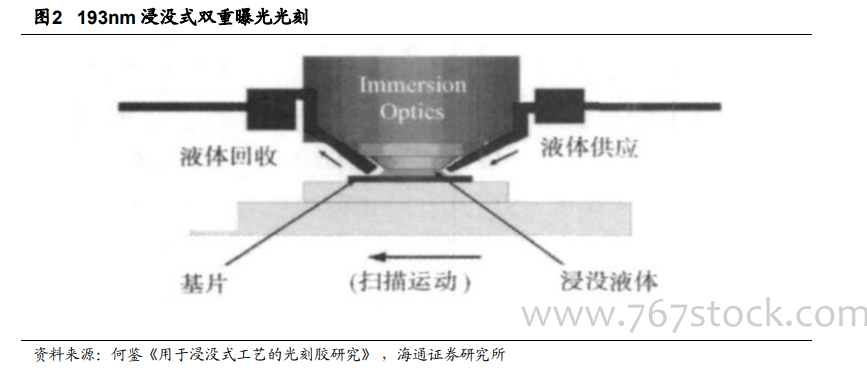
ArF 干法光刻膠和 ArF 濕法光刻膠均是晶圓制造光刻環節的關鍵工藝材料,ArF濕法光刻膠常用于更先進的技術節點。傳統的干法光刻技術中,光刻機鏡頭與光刻膠之間的介質是空氣,光刻膠直接吸收光源發出的紫外輻射并發生光化學反應,但在此種光刻技術中,光刻鏡頭容易吸收部分光輻射,一定程度上降低光刻分辨率,因此 ArF 干法光刻膠主要用于 55-90nm 技術節點;而濕法光刻技術中,光刻機鏡頭與光刻膠之間的介質是高折射率的液體(如水或其他化合物液體),光刻光源發出的輻射通過該液體介質后發生折射,波長變短,進而可以提高光刻分辨率,故 ArF 濕法光刻膠常用于更先進的技術節點,如 20-45nm。