工藝流程復雜,硅片制備是基礎步驟。半導體產業開始于上世紀。隨著1947年固體晶體管的發明,半導體行業已經獲得了長足發展,之后的發展方向是引入了集成電路和硅材料。集成電路將多個元件結合在了一塊芯片上,提高了芯片性能、降低了成本。隨著硅材料的引入,芯片工藝逐步演化為器件在硅片上層以及電路層的襯底上淀積。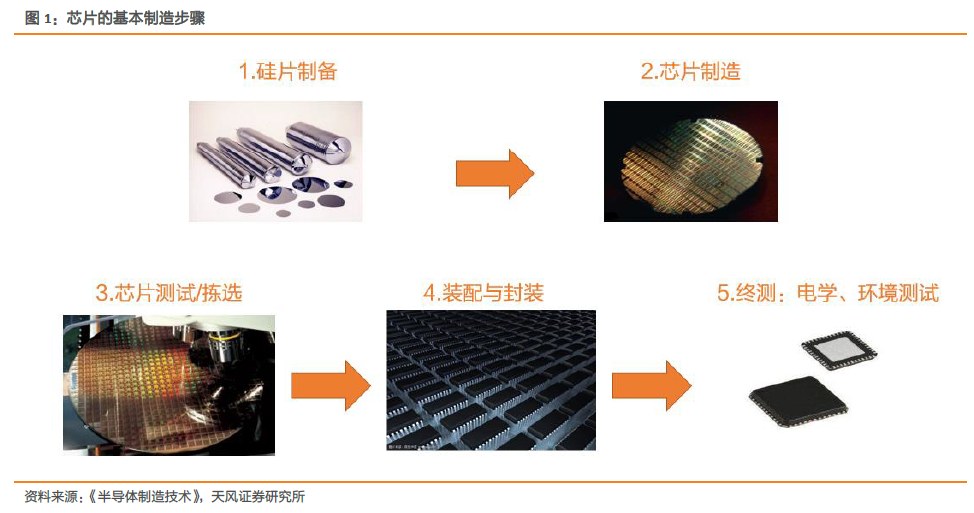
硅片制備環節所用設備眾多。硅片制備之前是制作高純度的半導體級硅(semiconductor-grade silicon,SGS),也被稱為電子級硅。制備過程大概分為三步,第一步是通過加熱含碳的硅石(SiO2)來生成氣態的氧化硅SiO;第二步是用純度大概98%的氧化硅,通過壓碎和化學反應生產含硅的三氯硅烷氣體(SiHCl3);第三步是用三氯硅烷經過再一次的化學過程,用氫氣還原制備出純度為99.9999999%的半導體級硅。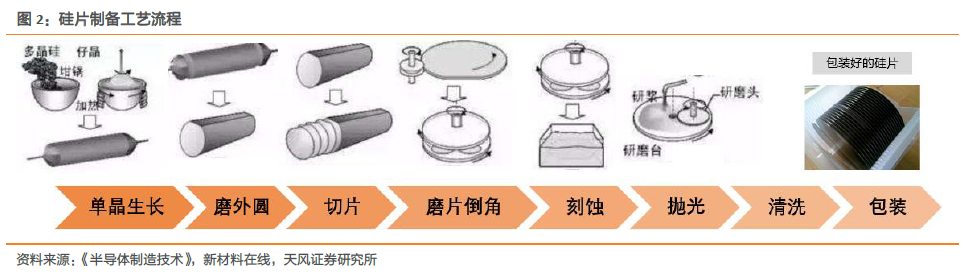
硅片尺寸加大和增加外延層是未來發展方向。硅片尺寸逐步加大是硅片發展的主要方向。硅錠直徑從20世紀50年代的初期的不到25mm增加到現在的300mm和400mm,隨著硅片直徑的不斷擴大,其厚度、面積、重量等技術參數都不斷增大。下圖主要展示了不同尺寸硅片的參數,可以看到400mm直徑硅片的面積是150mm硅片的7.5倍以上,重量則是150mm硅片的8倍以上。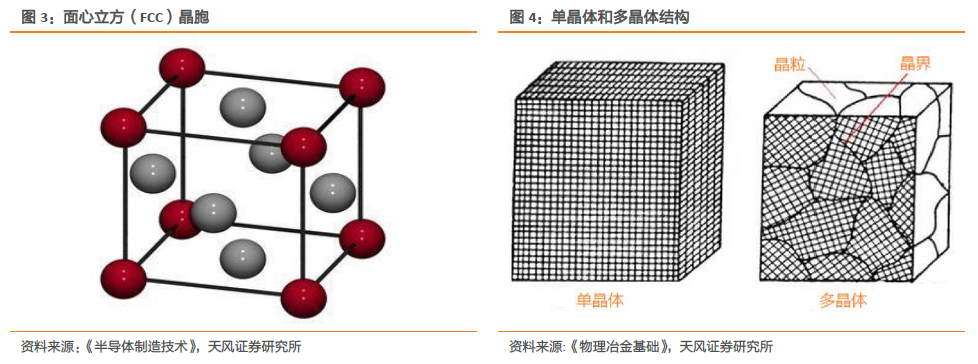
全球半導體行業高度景氣,大基金加持國內投資快速增加。全球半導體行業高度景氣。2016年開始全球半導體行業保持高景氣度,費城半導體指數和臺灣半導體行業指數一路上漲,分別由2016年初的600點左右和100點左右上漲至今年12月底的1270余點和160余點,增幅分別超過100%和70%。根據歷史經驗,行業復蘇持續時間一般不小于兩年 ,此輪景氣度周期始于2016年下半年,有望持續至2018年。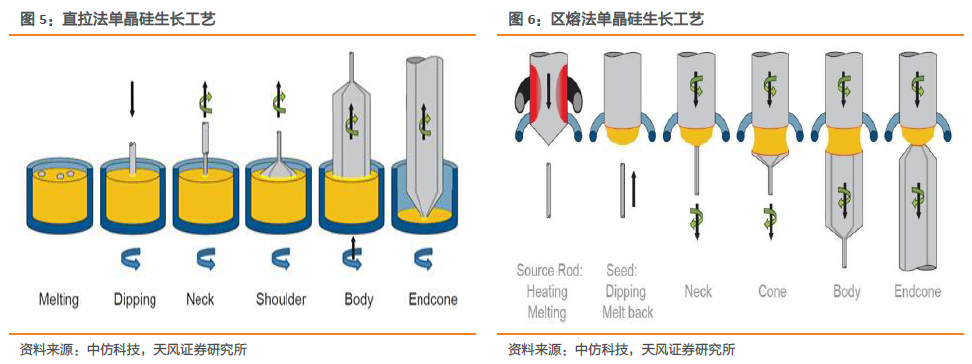
全球硅片供不應求,需求持續增加而產能增加緩慢。從各個尺寸的晶圓月產情況占比來看,大尺寸硅片市場持續擴大,擠壓200mm及以下市場空間。近年來300mm硅片占比持續提升,從2014年的61.1%上升到2020年的68.4%。150mm和200mm硅片的市場將被逐步擠壓,預計2020年二者合計占比由2014年的40%左右下降到2020年的30%左右,而更大尺寸450mm產能將在19年開始逐步投建。


