CMP(Chemical Mechanical Polishing,化學機械拋光)是半導體制造過程中實現晶圓全局均勻平坦化的關鍵工藝。晶圓制造過程主要包括7個相互獨立的工藝流程:光刻、刻蝕、薄膜生長、擴散、離子注入、化學機械拋光、金屬化。作為晶圓制造的關鍵制程工藝之一,化學機械拋光指的是,通過化學腐蝕與機械研磨的協同配合作用,實現晶圓表面多余材料的高效去除與全局納米級平坦化。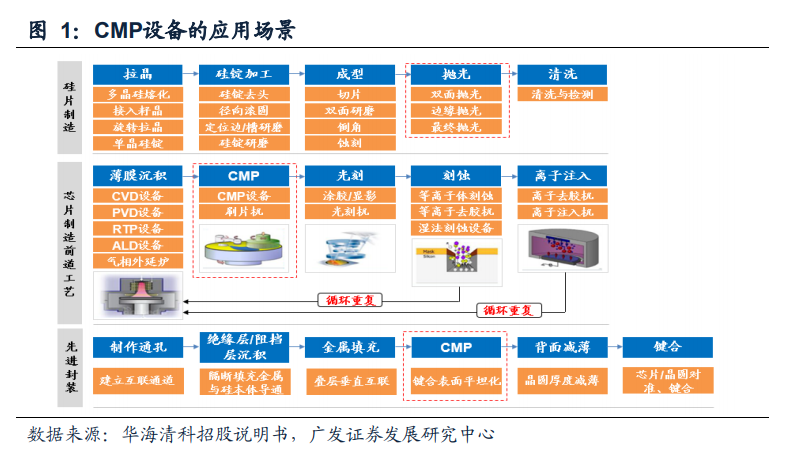
當前CMP已經廣泛應用于集成電路制造中對各種材料的高精度拋光。按照被拋光的材料類型,具體可以劃分為三大類:(1)襯底:主要是硅材料。(2)金屬:包括Al/Cu金屬互聯層,Ta/Ti/TiN/TiNxCy等擴散阻擋層、粘附層。(3)介質:包括SiO2/BPSG/PSG等ILD(層間介質),SI3N4/SiOxNy等鈍化層、阻擋層。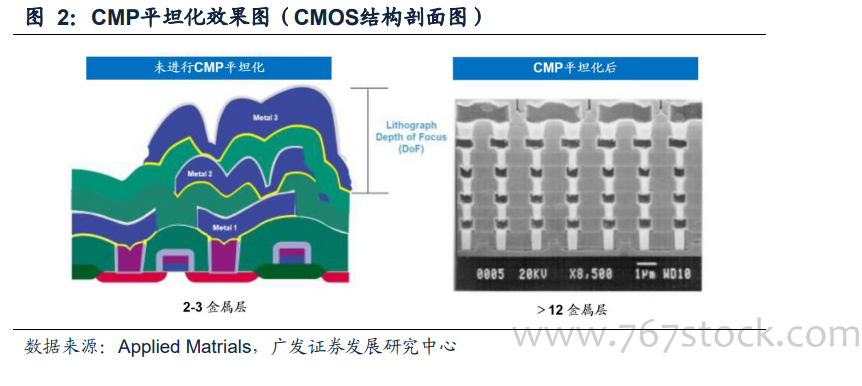
STI-CMP:淺槽隔離(STI)氧化硅拋光。在硅晶片上以反應性蝕刻形成溝槽后,以化學氣相沉積的方式沉積二氧化硅膜再將未被埋入凹溝內的二氧化硅膜以CMP去除。這樣就可以用二氧化硅膜作為元器件間的隔離,再用拋光速度相對緩慢的膜(例如氮化硅膜)來作為CMP的研磨停止層(Stoplayer)。