IC 載板又稱封裝基板,是連接并傳遞裸芯片(DIE)與印刷電路板 (PCB)之間信號的載體,可理解為一種高端 PCB 產品。IC 載板的功能主要是保護電路、固定線路與導散余熱,是封裝制程中的關鍵部件,其在低端封裝中成本占比 40-50%,高端封裝中占比 70-80%。在高階封裝領域,IC 載板已替代傳統的引線框架。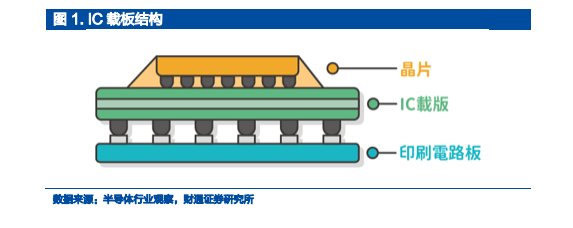
IC 載板相比 PCB 具有更高的技術要求。IC 載板由 HDI(高密互聯)技術發展而來,從普通 PCB 到 HDI 到 SLP(類載板)到 IC 載板,加工精度逐步提升。區別于傳統 PCB 的減成法,IC 載板主要采用 SAP(半加成法)與 MSAP(改良型半加成法)等工藝進行制造,所需設備有所不同,加工成本更高,線寬/線距、板厚、孔徑等指標更為精細,同時對于耐熱性要求也更高。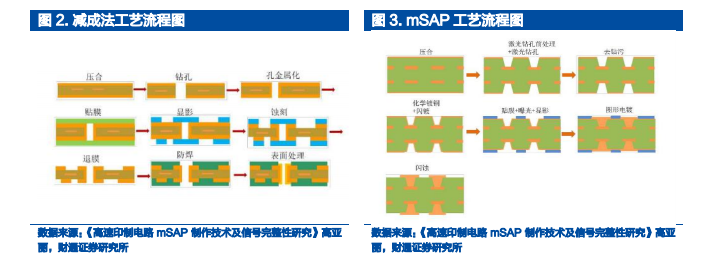
BGA/CSP 是載板與 PCB 之間的連接方式,CSP 適用移動端芯片,BGA 適用PC/服務器級高性能處理器。BGA(Ball Grid Array,球柵陣列封裝)是在晶片底部以陣列的方式布置許多錫球,以錫球陣列替代傳統金屬導線架作為接腳。CSP(Chip Scale Package,芯片級封裝)可以讓芯片面積與封裝面積之比超過 1:1.14,已經相當接近 1:1 的理想情況,約為普通的 BGA 的 1/3,可理解為錫球間隔及直徑更小的 BGA。從下游應用來看,FC-CSP 多用于移動設備的AP、基帶芯片,FC-BGA 用于 PC、服務器級 CPU、GPU 等高性能芯片封裝,基板具有層數多、面積大、線路密度高、線寬線距小以及通孔、盲孔孔徑小等特點,其加工難度遠大于 FC-CSP 封裝基板。


