芯片生產實現硅料—硅片—裸晶圓—成品芯片的轉變需要經過上千道工序,其中每一道工序都需要專門的半導體設備和特殊的半導體材料的協同。芯片生產分成硅片制造、晶圓加工和芯片封測三個環節:硅片制造從最初的多晶硅料通過拉晶、切磨拋、清洗、檢測等工序得到純凈度高達 99.999999999%(11 個 9)的單晶硅片;晶圓加工通過不斷重復熱處理、薄膜沉積、涂膠顯影、光刻、刻蝕、離子注入、CMP(化學機械拋光)、清洗等工序在單晶硅片上“雕刻”出集成電路得到裸晶圓;芯片封測通過減薄、切割、鍵合、塑封、測試等工序對裸晶圓進行封裝和品質檢測得到成品芯片。整個芯片生產過程累計會經過上千道工序,生產周期長達三個月,各種專門的半導體設備以及特殊的半導體材料正是成功完成各項工序的關鍵。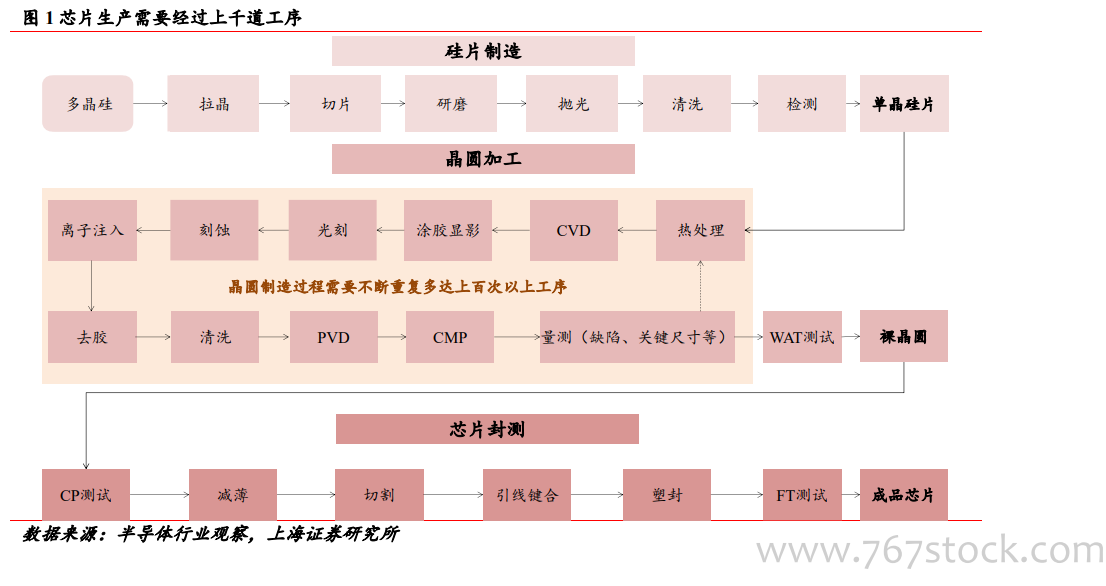
芯片生產過程會涉及超 50 種專門的半導體設備和超 300 種半導體材料,半導體設備、材料是支撐半導體產業穩步向前發展的底層基石。對應芯片生產的三個環節,半導體設備可分為硅片制造設備(<5%)、晶圓加工設備(80%)和芯片封測設備(10%+);對應具體的芯片生產工序以及工藝的不同,半導體設備擁有超 50種 的 細 分 類 型 , 例 如 刻 蝕 設 備 (ICP/CCP)、 沉 積 設 備(CVD/PVD/ALD)、光刻機(EUV/DUV/浸沒式)、清洗機(槽式/單片式)、量測設備(膜厚/缺陷/光學尺寸)、測試設備(測試機/分選機/探針臺)等。半導體材料一般可分為前道制造材料(60%+)和后道封裝測試材料(30%+),累計類別超 300 種。前道制造材料包括硅片、光掩模版、光刻膠及配套試劑、電子氣體、濕電子化學品、拋光液、拋光墊以及濺射靶材等,后道封裝測試材料包括有機基板、引線框架、鍵合絲、封裝樹脂、陶瓷材料、粘晶材料等。
半導體設備、材料市場均被海外占據主要份額,國產替代空間巨大。2020 年半導體設備市場前十大公司分別為應用材料、阿斯麥爾、泛林半導體、東京電子、科磊半導體、愛德萬、SCREEN、泰瑞達、日立高新和 ASMI,合計占據全球半導體設備市場 77%的份額。從半導體設備的細分市場競爭格局來看,各細分市場龍頭公司的平均集中度基本都在80%以上。半導體材料市場細分方向較多,相較設備市場而言細分市場的競爭格局略微分散一些,龍頭公司的平均集中度約在 60%-70%,仍主要被海外公司占據主要份額。國內公司目前在半導體設備、材料市場份額占比都非常低,國產替代空間巨大。


