IC 載板是半導體封裝的關鍵材料。集成電路產業鏈分為三個環節:芯片設計、晶圓制造和封裝測試。封裝不僅起到保護芯片和增強導熱性的作用,也可以連通外部的電路與芯片內部以達到固定芯片的作用。IC 封裝基板(IC PackageSubstrate,簡稱 IC 載板,也稱為封裝基板)是封裝測試環節中的關鍵載體,用于建立 IC 與 PCB 之間的訊號連接,IC 載板還能夠發揮保護電路,固定線路并導散余熱的作用。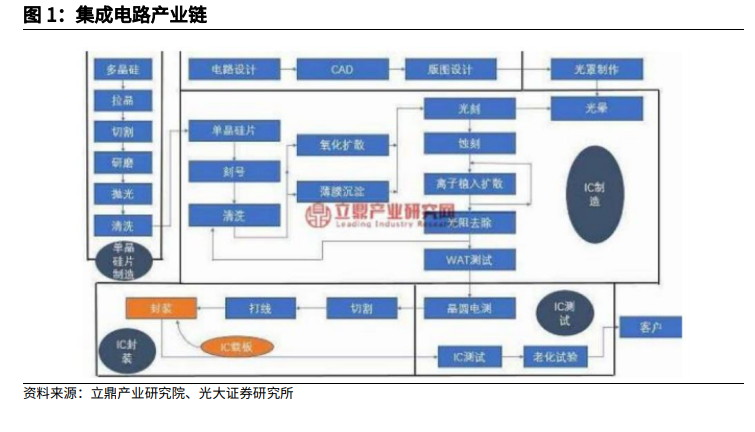
IC 載板被應用于主流的封裝技術中。半導體芯片封裝經歷了幾代的變遷,以封裝技術分類為 DIP 封裝(雙列直插式封裝技術)、SOP 封裝(小外形封裝)、QFP 封裝(小型方塊平面封裝)、PGA 封裝(插針網格陣列封裝技術)、BGA封裝(焊球陣列封裝)、SIP 封裝(系統級封裝)。技術的迭代與升級讓當前的封裝面積與芯片面積可以接近于 1。以 BGA(Ball grid array)封裝為例,它是一種高密度封裝技術,區別于其他封裝芯片引腳分布在芯片周圍,BGA 引腳在封裝的底面,使 I/O 端子間距變大,可容納的 I/O 數目變多。BGA 封裝憑借著成品率高、電特性好、適用于高頻電路等特點成為了目前主流的封裝技術之一。BGA 的基礎上逐漸衍生出 CSP,MCM 和 SIP 等高密度 IC 封裝方式。先進封裝技術更加迎合集成電路微小化、復雜化、集成化的特點,IC 載板因其高精度、高密度、小型化和薄型化的特點被廣泛應用于主流封裝技術中。
IC 載板制作工藝有兩種,分別為 SAP(半加成法)和 MSAP(改良半加成法),用于生產線寬/線距小于 25μm,工藝流程更加復雜的產品。SAP 和 MSAP 制作原理相似,簡述為在基板上涂覆薄銅層,隨后進行圖形設計,再電鍍上所需厚度的銅層,最終移除種子銅層。兩種工藝流程的基本差異是種子銅層的厚度。SAP工藝從一層薄化學鍍銅涂層(小于 1.5um)開始,而 MSAP 從一層薄的層壓銅箔(大于 1.5mum)開始。

