PVD 和 CVD 是主要的薄膜設備,ALD 是產業技術發展趨勢。在半導體領域,薄膜主要分給絕緣薄膜、金屬薄膜。大部分絕緣薄膜使用 CVD,金屬薄膜常用 PVD(主要是濺射)。其他常用的鍍膜方式包括 ECD、SOD、MOCVD、Epitaxy 等。在薄膜設備整體中,CVD的使用越來越廣泛,基于 CVD 發展的 ALD 更是行業升級的技術方向。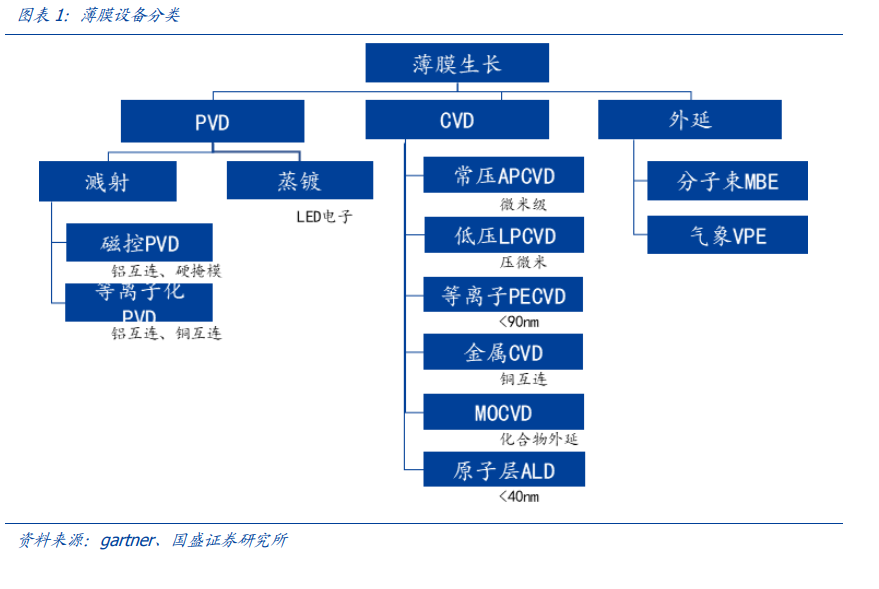
CVD:用于沉積介質絕緣層、半導體材料、金屬薄膜。典型的 CVD 流程包括氣體輸入、氣體對流、氣象擴散、表面吸附、表面反應、表面脫附及薄膜成核生長。(1)微米時代,化學氣相沉積多采用常壓化學氣相沉積(APCVD)設備,結構簡單。(2)亞微米時代,低壓化學氣相沉積(LPCVD)成為主流,提升薄膜均勻性、溝槽覆蓋填充能力。(3)90nm 以后,等離子增強化學氣相沉積(PECVD)扮演重要角色,等離子體作用下,降低反應溫度,提升薄膜純度,加強薄膜密度。(4)45nm 以后,高介電材料(High k)和金屬柵(Metal Gate),引入原子層沉積(ALD)設備,膜層達到納米級別。——(a)高介電材料(High k)替代 SiO2,用于制備 MOS器件的柵介質層,需要引入 ALD。(b)多晶硅同步地被替代為金屬柵(Matal Gate)電極,也用 ALD 設備制備。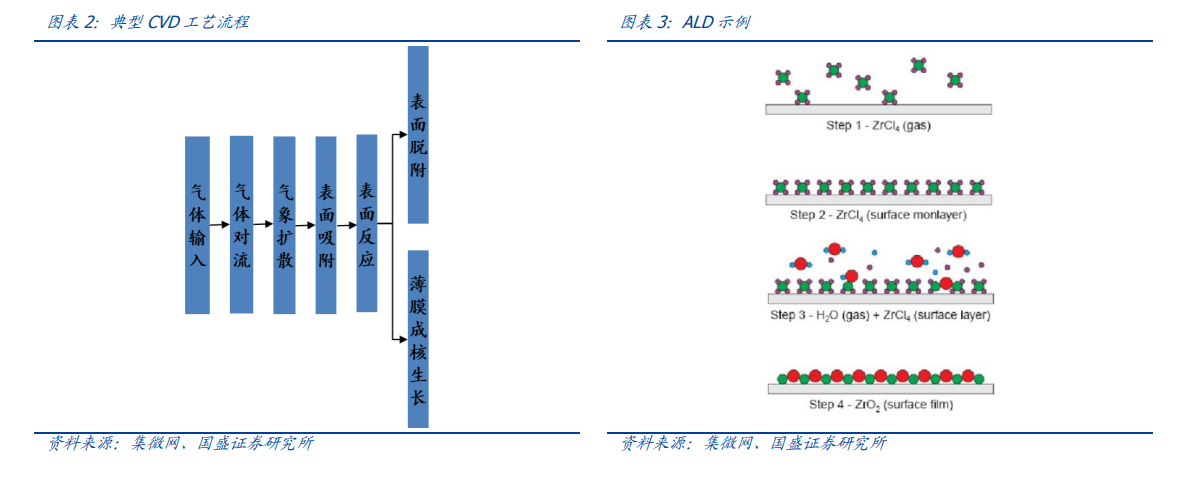
物理氣相沉積(PVD):利用蒸發或濺射,實現原子從源物質到沉底材料表面的物質轉移,沉積形成薄膜。物理氣相沉積是一種物理氣相反應生長法,沉積過程是在真空或低壓氣體放電條件下,涂層物質源是固態物質,經過“蒸發或濺射”后,在零件表面生成與基材性能完全不同的新的固態物質涂層。PVD 具有成膜速率高、鍍膜厚度及均勻性可控好、薄膜致密性好、粘結力強及純凈度高等優點。