刻蝕是使用化學或者物理方法有選擇地從硅片表面去除不需要材料的過程,常用的設備為刻蝕機等。通常的晶圓加工流程中,刻蝕工藝位于光刻工藝之后,有圖形的光刻膠層在刻蝕中不會受到腐蝕源的顯著侵蝕,從而完成圖形轉移的工藝步驟。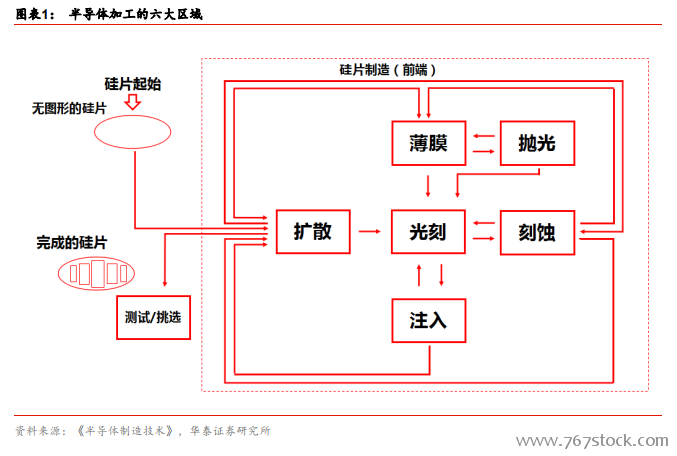
為在硅片表面材料上復制掩膜圖案,刻蝕需要滿足一定的參數,主要有:刻蝕速率、刻蝕剖面、刻蝕偏差和選擇比等。刻蝕速率指刻蝕過程中去除硅片表面材料的速度;刻蝕剖面指的是刻蝕圖形的側壁形狀,通常分為各向同性和各向異性剖面;刻蝕偏差指的是線寬或關鍵尺寸間距的變化,通常由橫向鉆蝕引起;選擇比指的是同一刻蝕條件下兩種材料刻蝕速率比,高選擇比意味著不需要的材料會被刻除。
刻蝕工藝主要分為兩種:干法刻蝕和濕法刻蝕。干法刻蝕是通過等離子氣與硅片發生物理或化學反應(或結合物理、化學兩種反應)的方式將表面材料去除,主要用于亞微米尺寸下刻蝕,由于具有良好的各向異性和工藝可控性已被廣泛應用于芯片制造領域;濕法刻蝕通過化學試劑去除硅片表面材料,一般用于尺寸較大情況,目前仍用于干法刻蝕后殘留物的去除。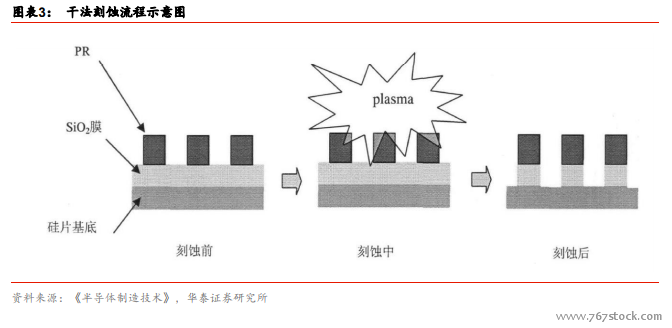
干法刻蝕是芯片制造領域最主要的表面材料去除方法,擁有更好的剖面控制。干刻蝕法按作用機理分為:物理刻蝕、化學刻蝕和物理化學綜合作用刻蝕。物理和化學綜合作用機理中,離子轟擊的物理過程可以通過濺射去除表面材料,具有很強的方向性。離子轟擊可以改善化學刻蝕作用,使反應元素與硅表面物質反應效率更高。綜合型干刻蝕法綜合離子濺射與表面反應的優點,使刻蝕具有較好的選擇比和線寬控制。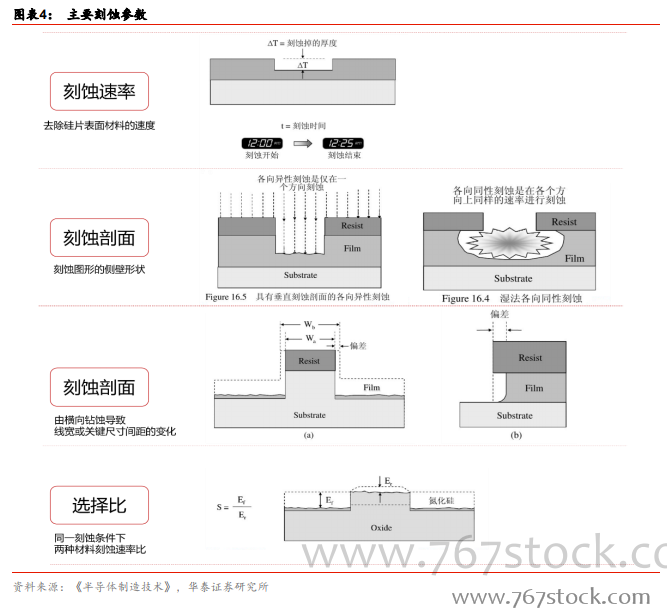
在集成電路制造過程中需要多種類型的干法刻蝕工藝,應用涉及硅片上各種材料。被刻蝕材料主要包括介質、硅和金屬等,通過與光刻、沉積等工藝多次配合可以形成完整的底層電路、柵極、絕緣層以及金屬通路等。