光刻膠作為影響光刻效果核心要素之一,是電子產業的關鍵材料。光刻膠由溶劑、光引發劑和成膜樹脂三種主要成分組成,是一種具有光化學敏感性的混合液體。其利用光化學反應,經曝光、顯影等光刻工藝,將所需要的微細圖形從掩模版轉移到待加工基片上,是用于微細加工技術的關鍵性電子化學品。因其在半導體等電子器件制造過程中的關鍵作用,光刻膠成為我國重點發展的電子產業關鍵材料之一。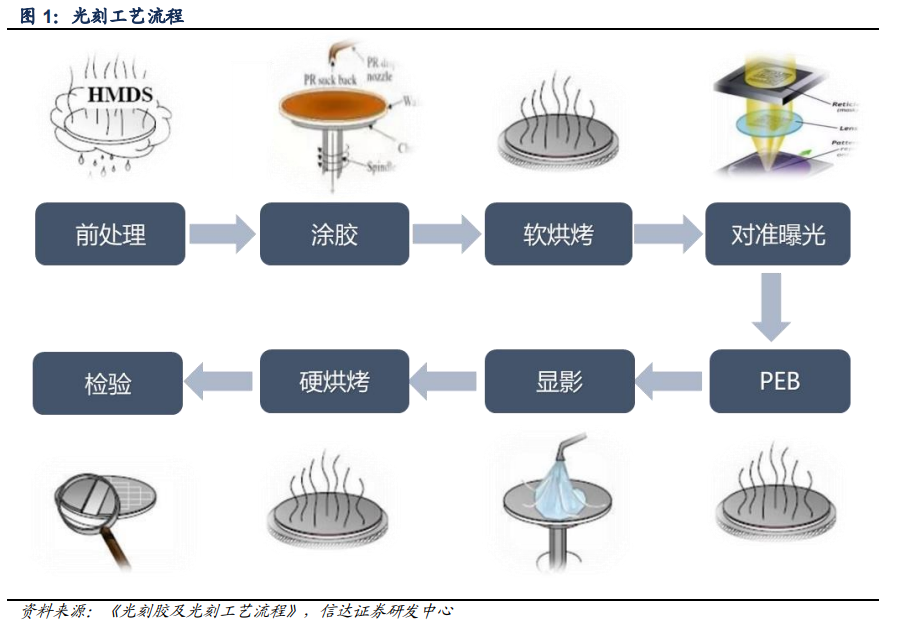
根據顯影效果不同,光刻膠可分正性光刻膠和負性光刻膠。正性光刻膠的曝光部分溶于顯影劑,顯影時形成的圖形與掩膜版上的圖形相同。負性光刻膠的曝光部分不溶解于顯影劑,顯影時形成的圖形與掩膜版相反。兩者的生產工藝流程基本一致。
正性膠已成為主流半導體光刻膠。負性光刻膠最早應用在半導體光刻工藝中,但由于顯影時易變形和膨脹,1970s 以后正性光刻膠成為主流。目前,在半導體光刻膠領域,g 線、i 線、ArF 線均以正膠為主。