手機輕薄化和高性能需求推動系統級整合。手機用戶既需要手機性能持續提升、功能不斷增加,也需要攜帶的便利性,這兩個相互制約的因素影響著過去 10 多年智能手機的更新換代過程:1)輕薄化。以 iPhone 手機為例,從最早機身厚度的約 12mm,到 iPhone XS 的 7.5mm,然而 iPhone11 的厚度增加到 8.5mm。2)功能增加、性能提升。手機逐步增加了多攝像頭、NFC 移動支付、雙卡槽、指紋識別、多電芯、人臉解鎖、ToF 等新功能,各個零部件的性能也持續提升,這些功能的拓展與性能提升導致組件數量日益增加,占用了更多的手機內部空間,同時也需要消耗更多的電能。然而,手機的鋰電池能量密度提升緩慢。因此,節省空間的模組化和系統級整合成為趨勢。
部分手機廠商已發布成品機型,但 5G 功能的實現對手機“輕薄”外觀帶來明顯挑戰,甚至功耗也不容小覷。早在 2018 年 8 月聯想就已發布 5G 手機 MOTO Z3,但其 5G 功能依賴掛載于手機背部、且自帶 2000mAh 電池的 5G 模塊。今年 2 月底三星正式發布 5G 版 S10,時隔不久華為也于3 月正式發布折疊屏 5G 手機 Mate X,其中華為 Mate X 由于機身展開厚度僅 5.4mm,最后只能將徠卡三攝、5G 基帶以及 4 組 5G 天線放置在側邊凸起。從以上幾款手機來看,5G 功能的實現還是對手機的“輕薄”外觀提出了明顯的挑戰,甚至功耗也不容小覷。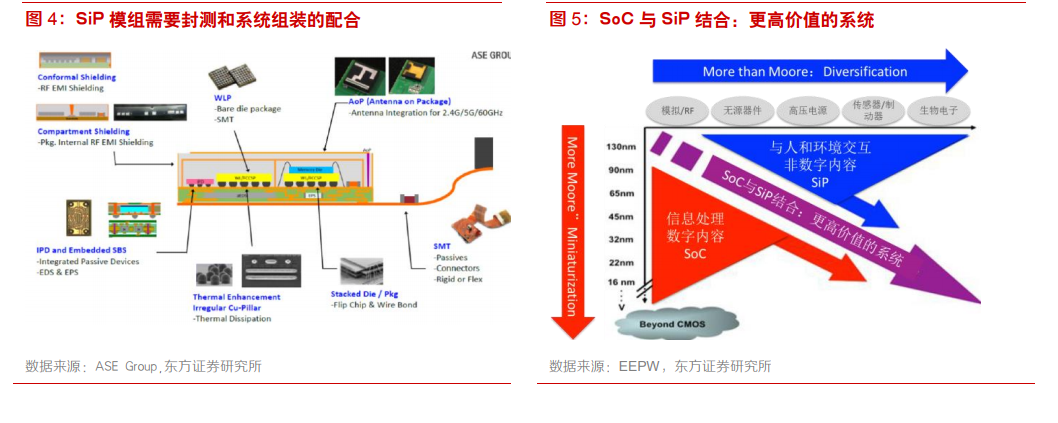
功能整合形成系統級芯片 SoC 和系統級封裝 SiP 兩大主流。兩者目標都是在同一產品中實現多種系統功能的高度整合,其中 SoC 從設計和制造工藝的角度,借助傳統摩爾定律驅動下的半導體芯片制程工藝,將一個系統所需功能組件整合到一塊芯片,而 SiP 則從封裝和組裝的角度,借助后段先進封裝和高精度 SMT 工藝,將不同集成電路工藝制造的若干裸芯片和微型無源器件集成到同一個小型基板,并形成具有系統功能的高性能微型組件。