一個完整的 ALD 周期可分為 4 個步驟:a)將氣相反應前驅體 A 以脈沖形式通入反應腔,在襯底表面發生化學吸附;b)待表面吸附飽和后,通入惰性氣體將剩余的反應前驅體和副產物帶出反應腔;c)將氣相反應前驅體 B 也以脈沖形式通入反應室,并與第一次化學吸附在襯底表面上的反應前驅體 A 反應;d)待反應完成后,再次通入惰性氣體將多余的反應前驅體和副產物帶出反應腔。通常一個周期需要 0.5 秒到幾秒,生長的薄膜厚度大約為 0.01~0.3nm,不斷重復循環這 4 個步驟即可完成整個 ALD 沉積過程。 典型的原子層沉積系統通常由前驅體源、氣路系統、電子控制系統和真空系統構成。一種傳統的、被廣泛使用的 ALD 方法是熱處理原子層沉積(Thermal ALD,TALD),即利用加熱法來實現原子層沉積的技術。不過由于常規 TALD 技術存在沉積速率較低、對某些沉積薄膜的沉積溫度要求較高等缺點,其在工業應用中受到限制。隨著原子層沉積在實驗中不斷優化,研究人員將 ALD 技術與其他技術或物質結合,一系列新的 ALD 技術得以產生和發展,例如等離子體增強原子層沉積(Plasma Enhanced ALD, PEALD)、空間原子層沉積(Spatial ALD,SALD)、電化學原子層沉積(Electrochemical ALD, ECALD)等等。
典型的原子層沉積系統通常由前驅體源、氣路系統、電子控制系統和真空系統構成。一種傳統的、被廣泛使用的 ALD 方法是熱處理原子層沉積(Thermal ALD,TALD),即利用加熱法來實現原子層沉積的技術。不過由于常規 TALD 技術存在沉積速率較低、對某些沉積薄膜的沉積溫度要求較高等缺點,其在工業應用中受到限制。隨著原子層沉積在實驗中不斷優化,研究人員將 ALD 技術與其他技術或物質結合,一系列新的 ALD 技術得以產生和發展,例如等離子體增強原子層沉積(Plasma Enhanced ALD, PEALD)、空間原子層沉積(Spatial ALD,SALD)、電化學原子層沉積(Electrochemical ALD, ECALD)等等。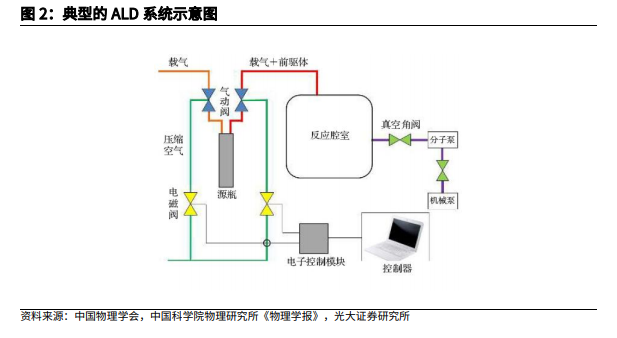 化學吸附自限制沉積(CS-ALD)過程中,第一種反應前驅體輸入到基體材料表面并通過化學吸附保持在表面。當第二種前驅體通入反應器,就會與已吸附于基體材料表面的第一前驅體發生反應。兩個前驅體之間發生置換反應,并產生相應的副產物,直到表面的第一前驅體完全消耗,反應會自動停止,并形成需要的原子層。而順次反應自限制原子層沉積(RS-ALD)是通過活性前驅體物質與活性基體材料表面發生化學反應來驅動的,即得到的沉積薄膜是由前驅體與基體材料間的化學反應形成的。ALD 就是這兩種自限制過程不斷重復形成薄膜的技術。
化學吸附自限制沉積(CS-ALD)過程中,第一種反應前驅體輸入到基體材料表面并通過化學吸附保持在表面。當第二種前驅體通入反應器,就會與已吸附于基體材料表面的第一前驅體發生反應。兩個前驅體之間發生置換反應,并產生相應的副產物,直到表面的第一前驅體完全消耗,反應會自動停止,并形成需要的原子層。而順次反應自限制原子層沉積(RS-ALD)是通過活性前驅體物質與活性基體材料表面發生化學反應來驅動的,即得到的沉積薄膜是由前驅體與基體材料間的化學反應形成的。ALD 就是這兩種自限制過程不斷重復形成薄膜的技術。